台積電今年推進混合封裝 日月光、艾克爾與英特爾借勢崛起
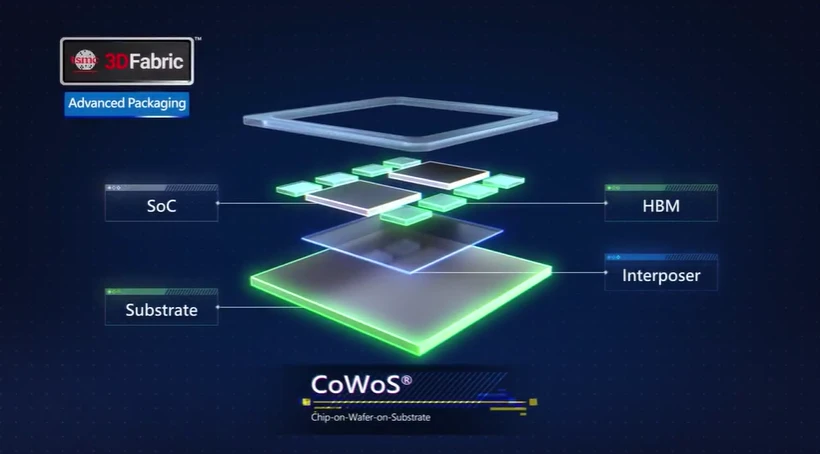

【記者蕭文康/台北報導】 隨著人工智慧(AI)與高效能運算(HPC)需求轉向多元化,先進封裝產業不僅供不應求也正迎來典範轉移。根據DIGITIMES觀察,2026年起,CoWoS與SoIC等先進封裝應用範圍從高階雲端AI加速器擴散至伺服器CPU、交換器、路由器與邊緣AI晶片等。而此趨勢不僅驅使台積電戰略性推進混合封裝,更帶動全球供應鏈從單一體系走向多軌並行的新格局。
台積電加速擴充CoWoS產能並以SoIC組合成混合封裝方案
由於CoWoS與SoIC等先進封裝成為AI時代異質整合的關鍵平台,其應用範圍正從最初的高階雲端AI加速器擴散至伺服器CPU、交換器、路由器與邊緣AI晶片,這些趨勢的驅動力來自於晶片核心數、I/O頻寬的爆炸性成長、SerDes速度提高,以及2與3奈米先進製程高昂的成本。
對此,DIGITIMES分析,全球先進封裝供應鏈將產生兩大變化。第一,台積電除加速擴充CoWoS產能外,也以SoIC為核心與CoWoS組合成混合封裝方案,鎖定2奈米世代的需求。DIGITIMES預估2026年年底台積電SoIC產能將年增122%,大幅升至2萬片,與CoWoS共同成為先進封裝重要基石。
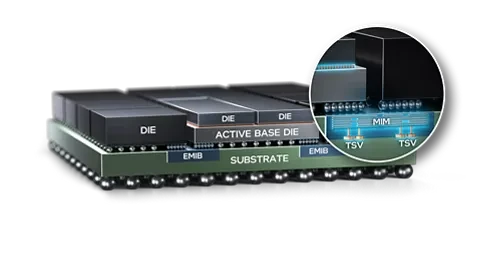

非台積電封裝體系日月光、艾克爾與英特爾崛起
第二,非台積電先進封裝體系崛起。在地緣政治風險分散與客戶尋求多重供應來源的需求下,全球先進封裝走向多軌並行的新格局。非台積電體系迅速崛起,如日月光投控,不僅是台積電OS (on Substrate)委外的核心夥伴,其自有先進封裝技術FoCoS發展亦有成。
艾克爾(Amkor)則先憑藉其2.5D TSV技術切入NVIDIA H20供應鏈,再以自有S-SWIFT技術獲得NVIDIA信賴封裝其GB10晶片,未來艾克爾將利用其美國亞利桑那廠區擴大美國在地化角色。
英特爾(Intel)則以其擁有的EMIB和Foveros兩大先進封裝技術,結合美國本土產能,滿足政策型訂單需求。
DIGITIMES認為,先進封裝產業已從過去的單一核心,轉變為去中心化,未來將走向異質整合技術深度、成本效率與區域化產能布局的綜合性策略競爭。
























